“芯事重重”半导体产业研究策划,本期聚焦DUV光刻机生产5nm的理论分析,独家发布腾讯新闻,未经授权,请勿转载。
作者 前台积电建厂专家 Leslie Wu(公众号:梓豪谈芯)
编辑 苏扬
你可能不知道,问世超过20年的DUV光刻机,还在发光发热。
使用浸润式DUV光刻机+多重曝光技术生产5nm芯片完全可行,不计代价的情况下甚至能做到3nm。
尽管理论上可行,且在7nm节点上已被部分晶圆厂验证过,但这需要诸多条件同时满足,比如多重曝光中关键的“套刻精度”——多次曝光之间图形对准的精度。
此外,也还涉及到许许多多的制程手段,比如相移光罩、模型光学临近效应修正、过蚀刻、反演光刻等,甚至基于最新的定向自组装光刻技术,在不依赖更高分辨率光刻的情况下,也有生产5nm芯片的可能。
当然,这么做需要付出高昂的成本,一般晶圆厂不会采用这种极端的手段来量产先进工艺芯片,毕竟主流的方案都是经过市场优胜劣汰,筛选出来的最符合商业逻辑的制造方式。
我们先从一个基础知识讲起,但如果你对工艺节点有系统的认知,可跳过第一部分。
01 5nm是文字游戏?
想要搞清楚浸润式光刻机+多重曝光到底能否做到5nm之前,需要先厘清什么是5nm。正好这两天,也有人把这个话题又拿出来吵,说ASML揭了晶圆厂的老底。
在展开说线宽的话题之前,我们需要知道,晶体管的作用,线宽在这里面扮演的价值。
晶体管通过栅极(Gate)来控制电路的导通和截止,导通代表1,截止代表0,以此来实现二进制计算。栅极长度(Gate length)越小,电流通过晶体管的源极(Source)、漏极(Drain)的速度就越快,即芯片的性能越强。
* 图1:MOSFET场效晶体管平面结构示意图
过去,晶体管的栅极长度被定义为线宽,和工艺节点名保持一致,光刻、沉积、刻蚀、扩散都是缩小线宽的核心制程。
随着FinFET、Nanasheet这些立体的晶体管结构的问世,半导体行业开始着重突出等效性能的概念——虽然叫14nm,但它的栅极长度远不止14nm。例如,英特尔的14nm工艺,栅极长度是24nm,台积电的7nm工艺,栅极长度是22nm。
另一方面,线宽并不能作为衡量晶体管密度的特征参数,这是因为即便线宽很小,但如果栅极之间的间距很大,单位面积内容纳的晶体管数量依然无法提升。这个时候,如果要表示元件的微缩程度,就需要引出另一个关键指标——周距(Pitch,也有节距的叫法),如下图。比如,过去1个单位面积下有9个晶体管,通过缩小周距,可容纳10个晶体管。
* 图2:线宽/栅极长度、周距与半周距的关系
90年代,0.35μm以前,工艺节点、半周距(Half pitch,即周距的一半)与栅极长度均一致,但在这之后,半周距、栅极长度与节点的对应关系出现分歧。从下面的图表我们可以清楚看出节点,半周距与栅极长度的关系与演变。
回到最开始的话题,当我们在说5nm的时候,其实只是在说它的制程节点,而并不是实际的线宽。
许多朋友喜欢说,现在各家半导体大厂宣称的多少nm工艺都是营销话术,严格意义上,20年前所有工艺节点都是如此。10年前,行业进入14nm的FinFET立体结构时代,则彻底地打破节点、周距、栅极长度与线宽的关联。
没有统一的标准自然会被企业拿来玩文字游戏模糊概念,三星在其14nm节点首开先河,台积电为了不落人后马上跟进,但保守的定义为16nm,只有自诩为“摩尔定律”坚定追随者的英特尔,当时还在死磕传统线宽的命名方式,直到2021年才全面修改节点命名,跟随竞争对手的节奏。
但这有问题吗?其实一点问题都没有。
晶体管早就从平面变为立体结构,如果我们把线宽的概念转化为单位晶体管密度(MTr/mm2,即每平方毫米百万晶体管数),会发现摩尔定律并没有消亡,只是以一种不同的形态继续生效——晶体管单位密度仍一直在增加——原本摩尔定律规定的就是“晶体管数量每18个月提升一倍”。
02 晶体管密度江湖里的搏杀
针对晶体管的各种特征尺寸多而复杂,每个厂商都有不同的定义设计,不同厂商相同制程工艺的产品也不完全具有可比性。
目前直观比较各家制程差异的唯一办法,就是回归摩尔定律的本质,对比晶体管密度,即单位面积内的晶体管数量。
根据上表的数据,在14nm节点英特尔、台积电、三星单位晶体管数量都是每平方毫米0.3亿颗左右。
10nm开始,英特尔将14nm+++改为Intel 10,名字是跟上了,但晶体管数量却成了倒






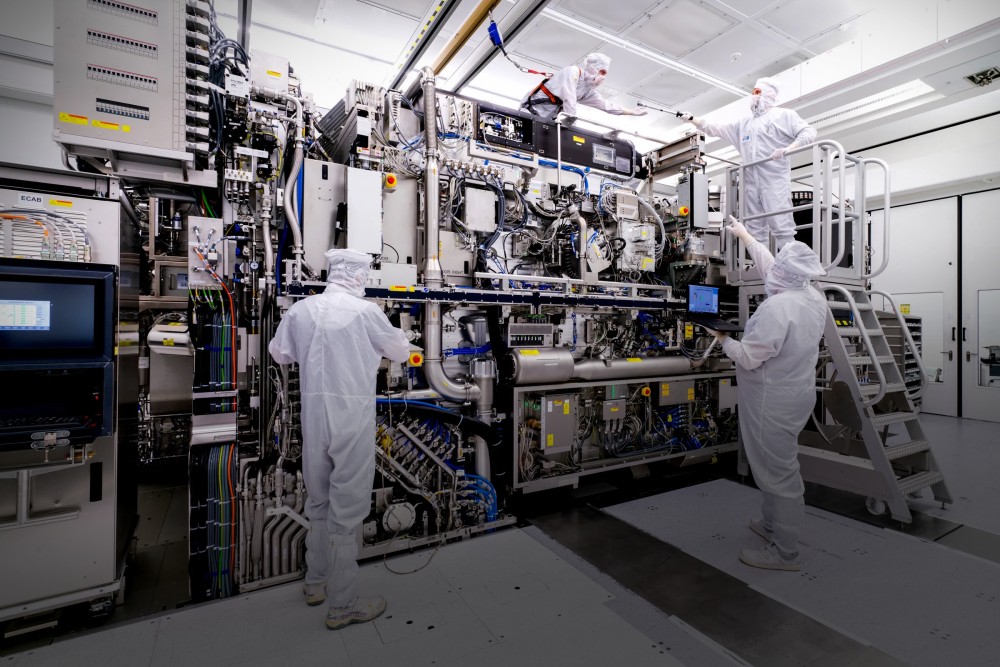
 相关论坛
相关论坛
 热门广告
热门广告
